后道(Back-End ),后道工序分为封装和测试两大工序。封装(Packaging)步骤依序为晶圆减薄(BackGrinding&Polish)晶片切割(die saw)、黏晶(die mount / die bond)、焊线(wire bond)、封胶(mold)、剪切/成形(trim / form)、印字(mark)、电镀(plating)及检测(inspection)等。量子器件中心现有的后道设备包含减薄机,切割机,贴片机,打线机。
| 设备名称 | 工艺能力 | 工艺展示 |
减薄机 WG-1211 | 可容纳6英寸及以下样品背面减薄,用于硅、锗、砷化镓等硬脆材料的精密减薄,公差±10μm,减薄厚度200um |
GaAs+GaAs键合样品减薄,减薄后厚度400um |
抛光机 LM-400 | 可兼容4英寸及以下三五族化合物半导体衬底模块背面抛亮,样品厚度在300um以上,仅提供次氯酸钠抛光液实现微米级抛光 |
InP衬底抛光 |
切割机 DAD3350 | 加工尺寸为最大Ø8英寸及其以下不规则样品。 通过配置不同的切割刀,能够对硅片、砷化镓、玻璃或其它加工材料进行机械切割加工 |
GaAs衬底切割 |
贴片机 ACCURA OPTO Flip Chip Bonder | ±0.5μm 超高精度(贴装精度 Placement Accuracy±0.1μm,键合后精度Post Bond Accuracy±0.5μm),Force up to 1000gr,chip尺寸<20mm*20mm ,component尺寸<50mm*50mm |
AlN衬底+ InP基光电探测器 Au Pad键合 |
打线机 Wire Bonder | 可实现细金丝/铝丝45度键合,可键合线径25um |
NbN薄膜,采用Al-Si线进行bonding |





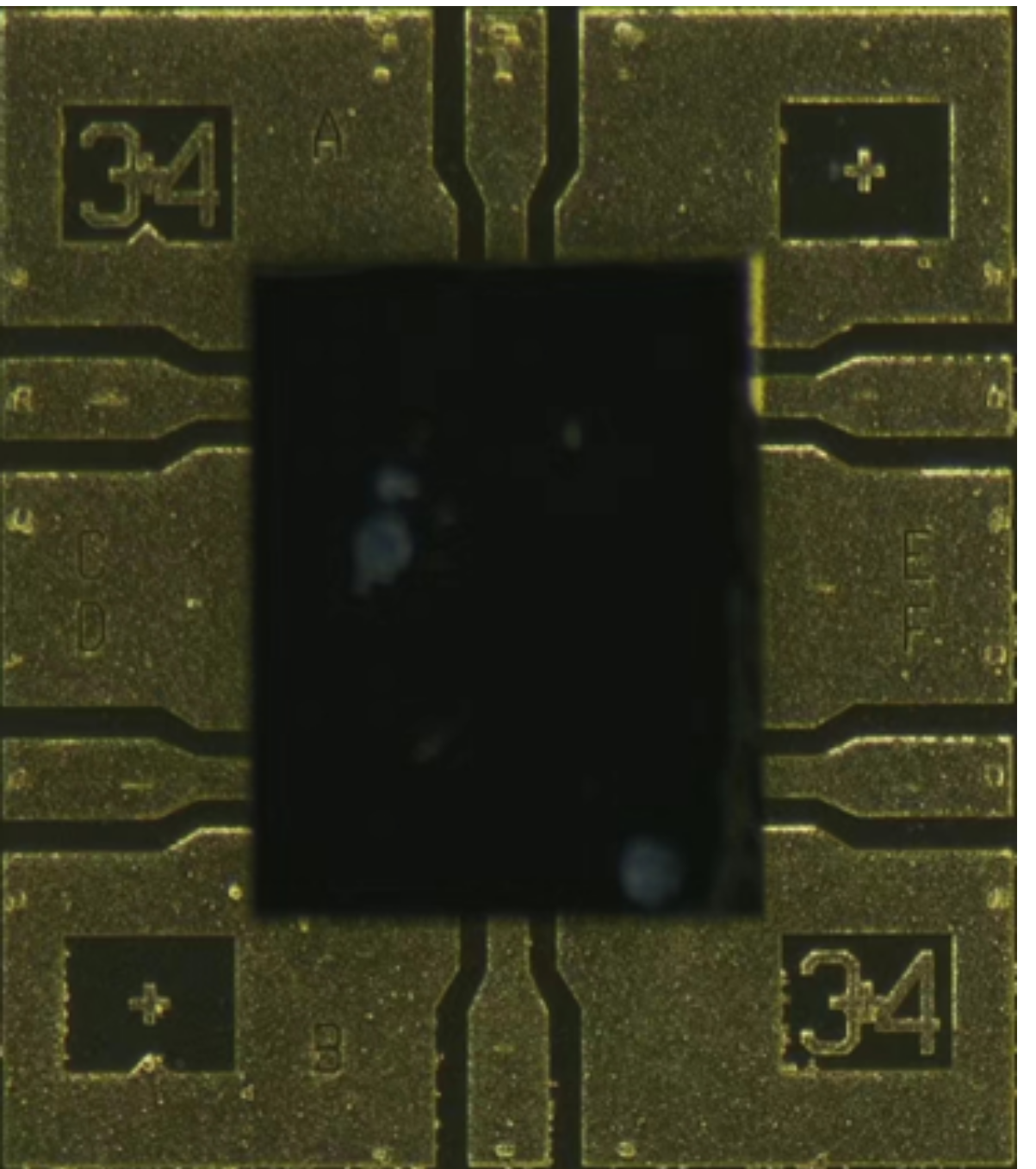




 首页
首页